Wirebond Packaging
tomy-asselin-lapointe
Wirebonding remains one of the most widely adopted methods in semiconductor assembly, connecting chips to substrates, substrates to substrates, or substrates to packages. We offer a full range of wirebond solutions across QFN, DFN, QFP, WB-BGA, and WB-LGA formats — with materials including gold, copper, silver, and palladium-coated wire. Backed by high-volume manufacturing and billions of units shipped, our platforms serve power, memory, MEMS, mobile, automotive, and beyond.

Flip Chip Packaging
sebastien-roy
Flip chip technology enables direct die-to-substrate connections through solder bumps — reducing parasitics, improving thermal efficiency, and shrinking form factors.
We support a broad range of flip chip formats including fcCSP, fcBGA, C2W, and 3DIC. Applications span from large single-die packages with thermal enhancements to compact modules and AiP designs with embedded antennas.

Wafer Bumping
margaux-pietri
Wafer bumping enables high-density interconnects directly at the wafer level. It supports improved electrical performance, tighter form factors, and lower overall cost.
We provide bumping and redistribution services for 200mm and 300mm wafers, including redistribution and full turnkey support for flip chip and wafer-level packaging. Our process capabilities span printed bump, ball drop, and plated bumping with lead-free and copper pillar alloys—optimized for reliability and production scale.
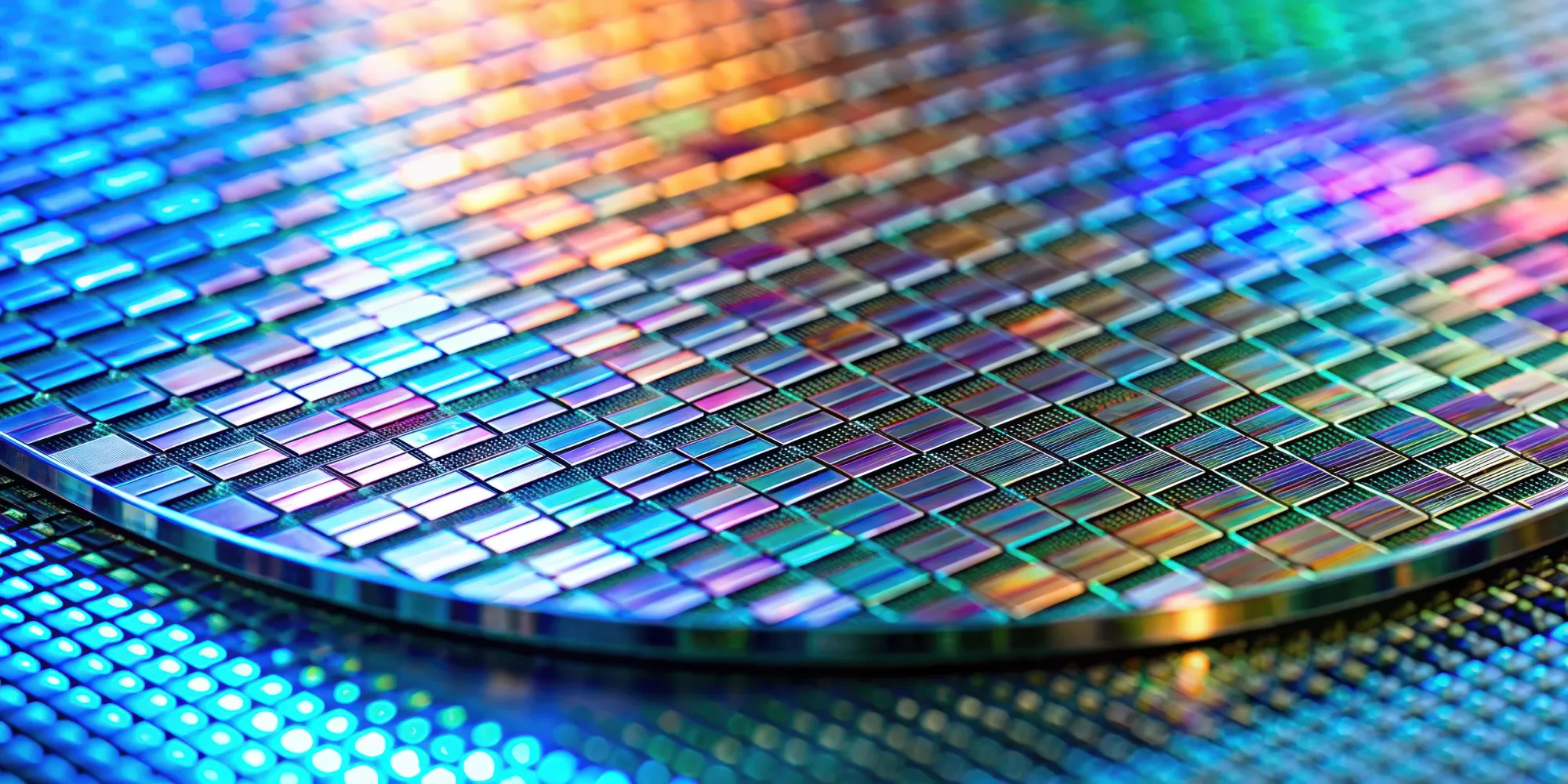
Wafer Level Packaging
simon-bedard
Wafer-level packaging integrates more functionality directly at the wafer stage, reducing size and improving power, speed, and signal integrity. It’s key to enabling next-gen devices that demand performance without compromising footprint or cost.
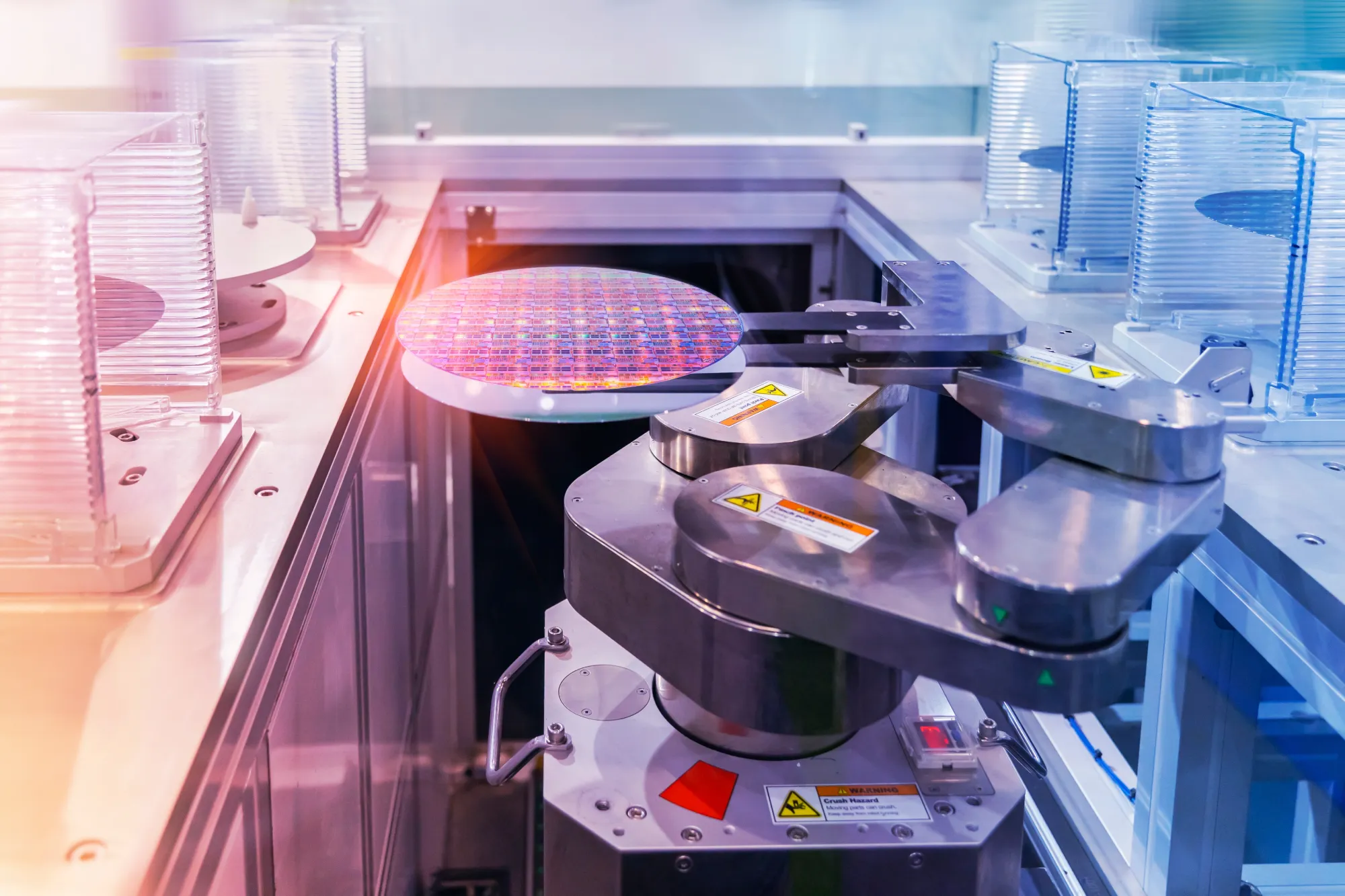
System-in-Package
sebastien-moise
System-in-Package (SiP) combines multiple chips and components into a single compact module, enabling faster processing, higher performance, and more functionality in less space.
Our platforms support heterogeneous integration of logic, analog, power, and memory ICs using SMT, wirebond, and flip chip. Advanced technologies include:
- Dual-sided molding – reduces package size, shortens routing, lowers resistance, and improves system performance
- EMI shielding – enhances thermal conductivity and signal integrity via backside metallization
- Laser-assisted bonding (LAB) – overcomes traditional reflow issues like warpage, stress, and CTE mismatch for improved reliability

MEMS & Sensors Packaging
melanie-laviolette
MEMS and sensor packaging enables real-time sensing, responsiveness, and control in compact, power-efficient designs. These technologies are foundational across communications, automotive, medical, industrial, and consumer systems.
Our dedicated MEMS team supports full turnkey development including packaging co-design, simulation, BOM qualification, assembly, testing, and quality assurance. We deliver highly integrated, size-optimized solutions that meet the performance and cost demands of modern sensing applications.

2.5 / 3D Packaging
alexia-rancourt
Advanced 2.5D and 3D packaging stacks and interconnects multiple components to maximize functionality and performance.



